|
在锡膏印刷工艺中,塌陷是指印刷后的锡膏无法维持预期形状,出现边缘垮塌、向焊盘外侧蔓延,甚至在相邻焊盘间形成桥接的现象。这一缺陷会显著影响焊接质量,导致短路或虚焊等问题。塌陷的形成是多种因素共同作用的结果下面是详细分析及优化方案:
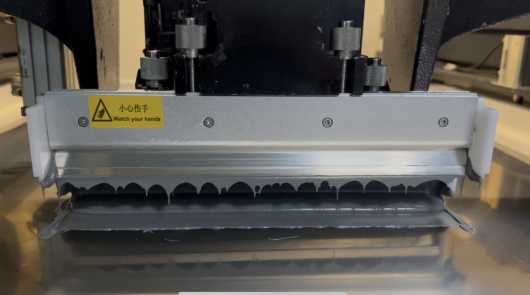
一、塌陷的核心成因 1. 刮刀压力失控 原理:刮刀压力过大时,锡膏在通过钢网孔洞时会被过度挤压,导致部分锡膏渗入钢网与PCB的间隙。若压力持续过高,相邻焊盘的锡膏可能因挤压而连接,形成塌陷。 典型场景:细间距元件(如0.4mm pitch以下的QFP、BGA)印刷时,刮刀压力稍大即易引发短路。 2. 锡膏流变特性异常 黏度不足: 原因:剂挥发、金属含量异常(如助焊剂比例过高)或环境湿度过高,均会导致锡膏黏度下降。 影响:低黏度锡膏印刷后边缘松散,难以维持形状,尤其在细间距焊盘上易扩散。 金属颗粒尺寸不匹配: 问题:小颗粒锡膏(如T6级)虽下锡性好,但印刷后形状保持性差,易因表面张力作用而塌陷。 案例:0.3mm间距元件使用T6级锡膏时,塌陷风险显著增加。 3. 环境因素干扰 湿度过高:锡膏吸湿后稀化,黏度降低,导致塌陷。例如,在湿度>60% RH的环境中,未密封的锡膏可能因吸湿而失效。 温度波动:高温会降低助焊剂黏度,使锡膏在印刷后流动过度;若时间过长,稀释剂挥发又会导致黏度回升,引发印刷困难。 4. 工艺参数与设备缺陷 钢网设计不合理: 开孔过大:钢网开孔面积超过焊盘95%时,或钢网过厚,下锡量超标,多余焊料在重力作用下流淌,形成塌陷。 倒角缺失:钢网孔壁垂直或内凹设计会增加锡膏脱模时的应力,导致边缘不整齐。 脱模速度过快:快速脱模可能拉扯锡膏,使其边缘呈锯齿状或塌陷。 设备状态不佳:钢网底部沾污、刮刀磨损或PCB支撑不足,均可能间接引发塌陷。
二、系统性优化方案 1. 精准控制刮刀压力 调整策略: 通过试验确定最佳压力范围(通常为0.1-0.3N/mm),确保锡膏均匀填充钢网孔洞且不渗入间隙。 使用压力传感器实时监测,避免人工调整误差。 案例:某SMT线通过将刮刀压力从0.35N/mm降至0.25N/mm,细间距元件塌陷率降低80%。 2. 优化锡膏选择与管理 黏度匹配: 根据元件间距选择合适黏度的锡膏(如细间距选用高黏度、快干型锡膏)。 避免使用过期或二次回收的锡膏,防止金属含量异常。 颗粒尺寸控制: 常规间距(≥0.5mm)选用T4级(20-38μm)锡膏。 细间距(0.3-0.4mm)选用T5级(15-25μm)锡膏,避免使用T6级。 存储与使用: 锡膏需冷藏(0-10℃)保存,使用前回温至室温(≥4小时)。 印刷过程中每2小时搅拌一次,防止金属颗粒沉降。 3. 严格环境管控 温湿度控制: 印刷车间温度保持在23±3℃,湿度控制在40%-60% RH。 使用除湿机或加湿器动态调节,避免锡膏吸湿或干燥过快。 局部防护: 在钢网下方安装防尘罩,减少环境污染物对锡膏的干扰。 4. 改进钢网设计与脱模工艺 钢网优化: 开孔面积控制在焊盘的90%-95%,并设计倒角(如0.1mm圆角)减少应力集中。 使用电抛光钢网,降低孔壁粗糙度,提升脱模顺畅性。 脱模参数调整: 脱模速度设置为0.5-1mm/s,与印刷速度匹配。 采用分段脱模(如先缓慢抬起0.1mm,再快速脱离),减少锡膏拉扯。 5. 设备维护与操作规范 定期保养: 每周清洗钢网,去除底部残留锡膏和助焊剂。 检查刮刀刀片磨损情况,及时更换(刀片边缘圆角半径应<0.1mm)。 PCB固定: 使用多点夹紧装置固定PCB,防止印刷过程中移动导致锡膏偏移
三、效果验证与持续改进 检测方法: 使用2D/3D SPI(锡膏检测仪)量化塌陷高度和面积,设定阈值(如塌陷高度>0.1mm为NG)。 通过X-Ray检查焊接后桥接率,验证优化效果。 持续改进: 建立DOE(实验设计)模型,分析刮刀压力、锡膏黏度、环境湿度等参数的交互影响。 定期复盘生产数据,针对高频塌陷问题调整工艺窗口。 通过上述改进方法,可显著降低锡膏印刷塌陷率,提升焊接良率至99.5%以上。关键在于结合设备特性、材料性能和环境条件,制定精准的工艺控制方案,并持续监控与改进。
版权声明
“特别声明:以上作品内容(包括在内的视频、图片或音频)为用户上传并发布,本平台仅提供信息存储空间服务。
Notice: The content above (including the videos, pictures and audios if any) is uploaded and posted by the user , the platform merely provides information storage space services.”
本文地址: https://www.amtbbs.org/thread-17939-1-1.html
|  |联系我们|法律声明|用户协议|AMT咨询|商务合作|会员入驻|积分充值|积分商城|积分奖励规则|TradEx全球购|加入QQ技术群|添加企业微信|加入微信技术群|智造号|手机版|
世界先进制造技术论坛™(简称AMT™, 智造云™)
( 沪ICP备12020441号-3 )
|联系我们|法律声明|用户协议|AMT咨询|商务合作|会员入驻|积分充值|积分商城|积分奖励规则|TradEx全球购|加入QQ技术群|添加企业微信|加入微信技术群|智造号|手机版|
世界先进制造技术论坛™(简称AMT™, 智造云™)
( 沪ICP备12020441号-3 )
